发布日期:2018/7/19
发布单位:iST宜特
WLCSP IC,锡球、RDL层覆盖了电路层,该如何进行FIB线路修补?
什么是WLCSP(Wafer Level CSP)晶圆级芯片封装技术,这意指在晶圆切割前,利用锡球来形成接点,直接在晶圆上完成IC封装的技术,比起传统打线封装,可有效缩减封装体积;面对穿戴式、智能手持式装置轻薄化的趋势,具有面积最小、厚度最薄等特征的WLCSP封装方式,也受到越来越多厂商采用。
然而此封装形式的IC产品,在进行FIB线路修补时将面临到两大挑战,一是IC下层的电路,绝大部分都会被上方的锡球(Solder Ball)与RDL(Redistribution Layer, 线路重布层)给遮盖住,这些区域在过往是无法进行线路修补的。二是少数没有遮盖到的部分,也会因上方较厚的Organic Passivation(有机护层),大大增加线路修补的难度与工时(见下图)。
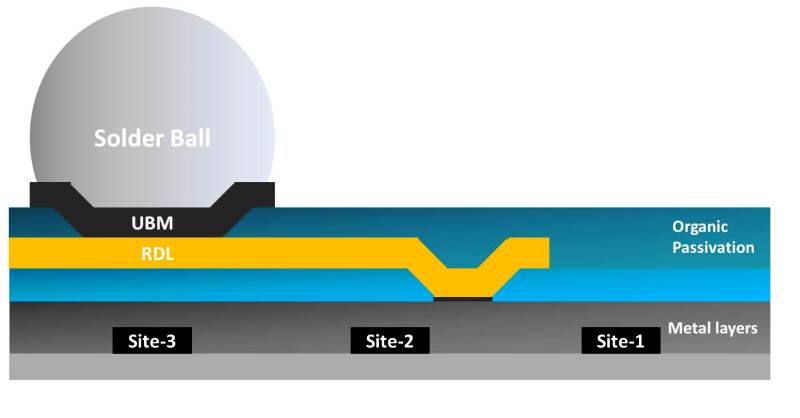
为此,宜特开发了WLCSP电路修改技术;为WLCSP制程所研发的蚀刻技术手法,无论要修改的目标区电路是覆盖在Organic Passivation(有机护层)、或是RDL(重布线路层,Redistribution Layer)、甚至锡球(Solder Ball)下方皆可进行电路修改;此技术至今,已为全球IC设计公司,包括电源管理、模拟、多媒体IC设计等企业,解决2450件超过4600颗的WLCSP电路修改问题。
本月小学堂,我们从这2450件超过4600颗的WLCSP电路修改案件内,归纳出几项客户常见问题。
Q1: 想修改的WLCSP IC的电路位置,被锡球覆盖,宜特进行线路修补后,该锡球还能够使用吗?
此分两面向探讨,第一,若您要做线路修补的位置,是在锡球边缘,宜特可以提供「不破坏锡球高度并维持一定锡量」的局部锡球去除技术,在完成线路修补后,该颗样品即可上到Socket或焊接到PCB上,进行后续电性测试。
第二,若您要做的线路修补位置,接近锡球中间下方,宜特将协助您移除该颗锡球,并在完成线路修补后,提供新的锡球植入,您一样可以无缝接轨的进行后续实验测试。
因此,在宜特WLCSP电路修改解决方案下,可以确保锡球功能正常与测试。
宜特移除局部锡球技术
修改位置在錫球邊緣時,僅需移除局部錫球,執行FIB電路修改後,可立即進行PCB焊接或直接上到Socket進行電路測試,加速您Debug時效。
宜特移除全部锡球技术
修改位置接近錫球中間時,選擇移除全部錫球,執行FIB线路修补後,搭配Laser Re-ball技術精準植球,提升整體電路修改可行性與成功率。
Q2: 已执行过FIB电路修改及焊接测试的WLCSP IC样品,还可以二次进行电路修改吗?
答案是可以。进行焊接测试后的WLCSP IC样品,从测试板上拔下欲二次进行FIB电路修改,IC上的锡球将会是破碎不完整,因此,第一步骤必须先将WLCSP表面破碎的锡球清除干净,第二步骤,即可二次进行FIB线路修补技术,完成后,搭配宜特Laser Re-ball技术,精准植回锡球,您即可快速进行后续电性测试。
Q3: 如何有效率的植回锡球,且不影响后续可靠度验证精准度?
以往,植回锡球的方式是人工摆球,以全面加热方式让锡球溶融后,接合于WLCSP IC的UBM层(Under Barrier Metal),此方式非常耗时; 且若其样品是有PCB底板的产品(Ex BGA封装型式的IC),加热的过程,很容易因PCB板材内藏有水气,受到高温影响,产生爆板现象,进而影响可靠度验证精准度。
为此,宜特引进以雷射的方式植入锡球之技术(Laser Re-ball),藉此将可大幅提升作业效率与线路修补良率。
本文与各位长久以来支持宜特的您,分享电路修改经验,若您有WLCSP电路修改问题、锡球植回需求,或是对相关知识想要更进一步了解细节,欢迎洽询中国免费咨询电话,400-928-9287│ Email: marketing_chn@istgroup.com