
功率半导体进行「 晶圆减薄 」是改善工艺,使得功率组件实现「低功耗、低输入阻抗」最直接有效的方式。 但如何在减薄工艺中降低晶圆厚度,又同时兼顾晶圆强度,避免破片率居高不下之风险…
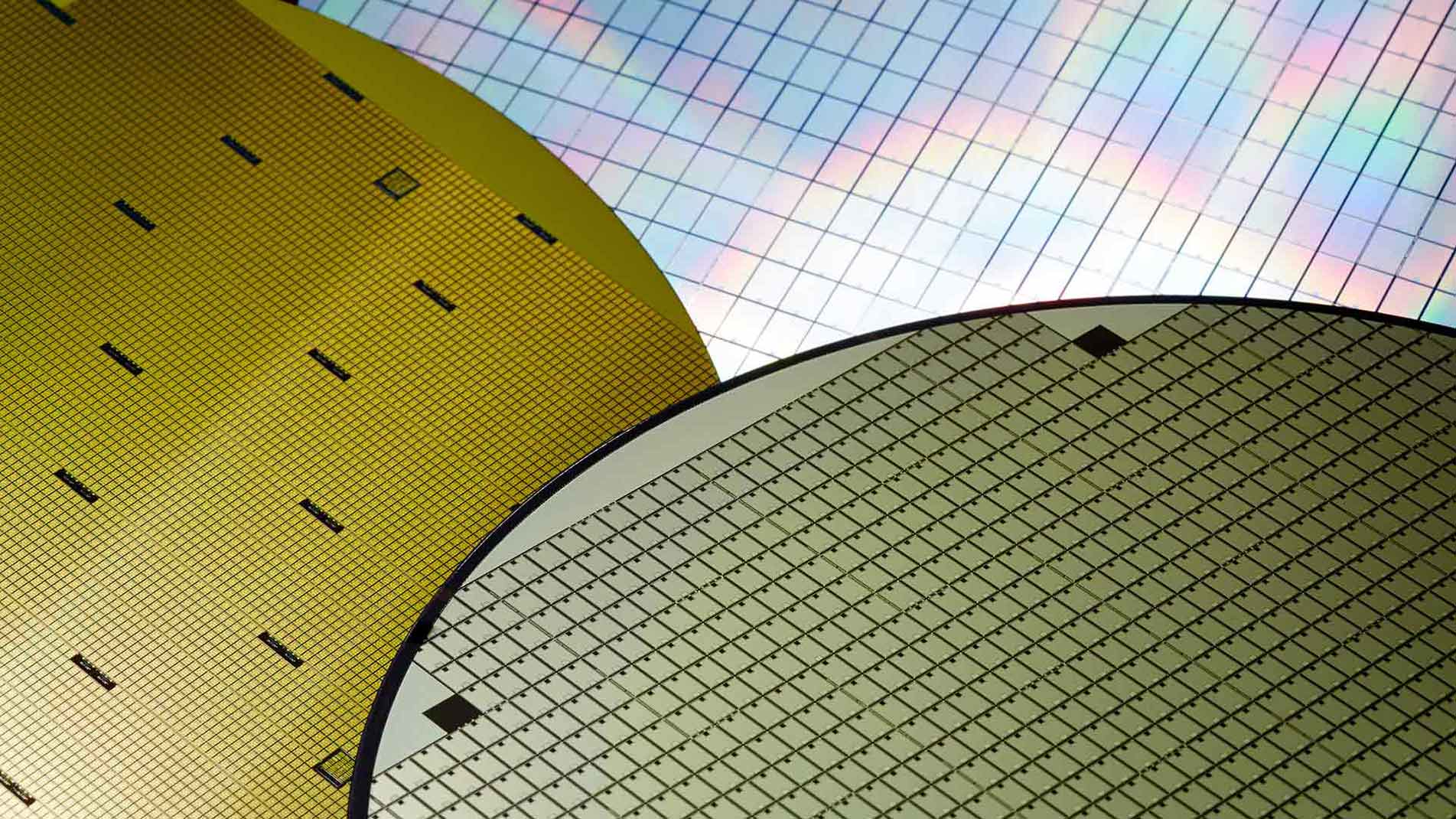
化学镀工艺最大特色是,只需利用一系列的氧化还原反应,将镍金/镍钯金选择性的成长在铝垫上,完全不需要经过高真空溅镀/黄光工艺/蚀刻工艺,因此成本可降低…

正面金属化工艺是MOSFET晶圆减薄的一个关键工艺,正面金属化工艺的目的,就是藉由溅镀或化学镀方式形成UBM,接着做铜夹焊接 (Clip Bond),以降低导线电阻….
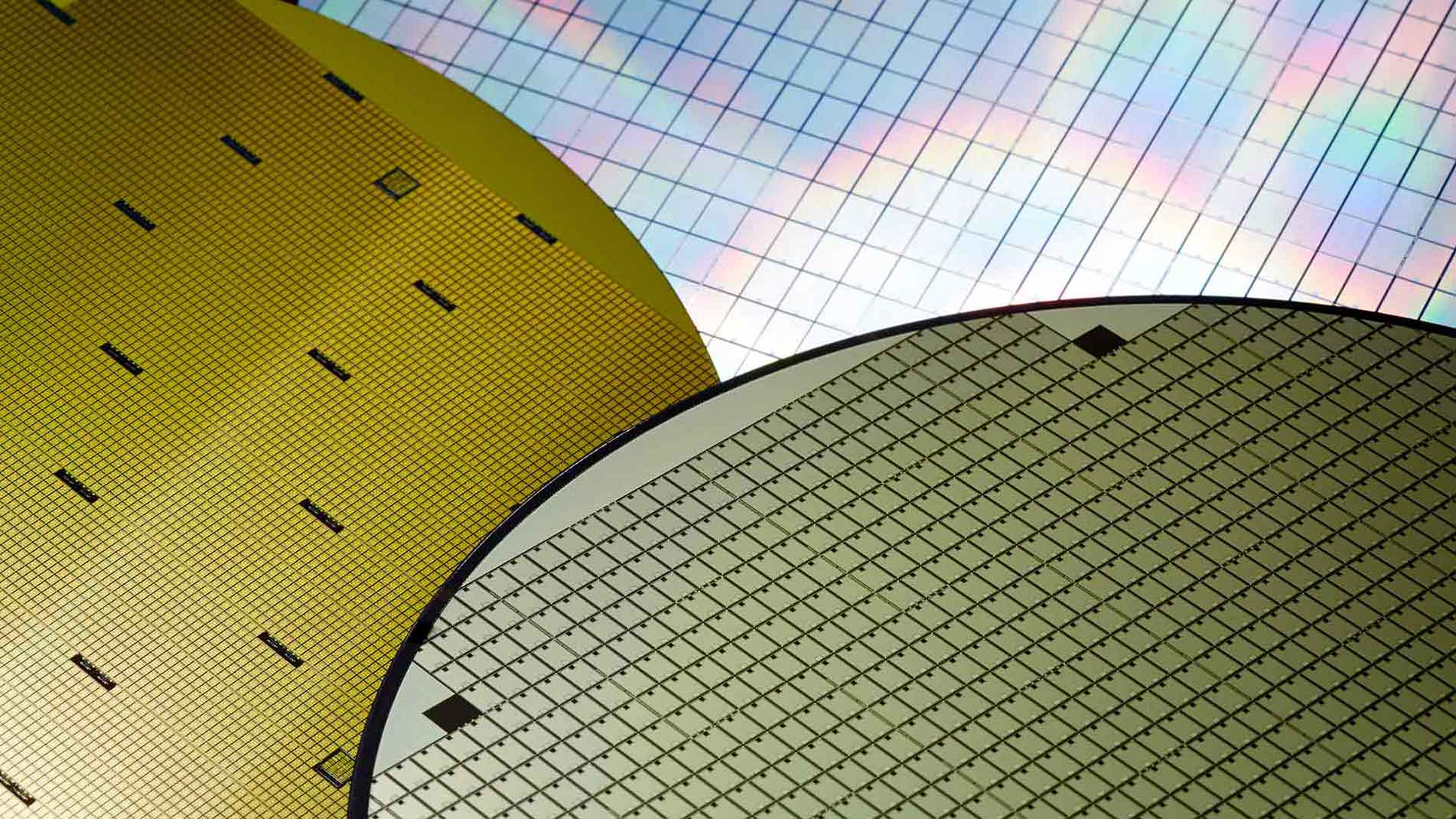
MOSFET组件供不应求,IDM又产能满载,交期大幅拉长怎么办?完成了晶圆薄化与表面处理,后续又得将晶圆转运去做CP和切割,有没有一次就做到好的厂商?
