
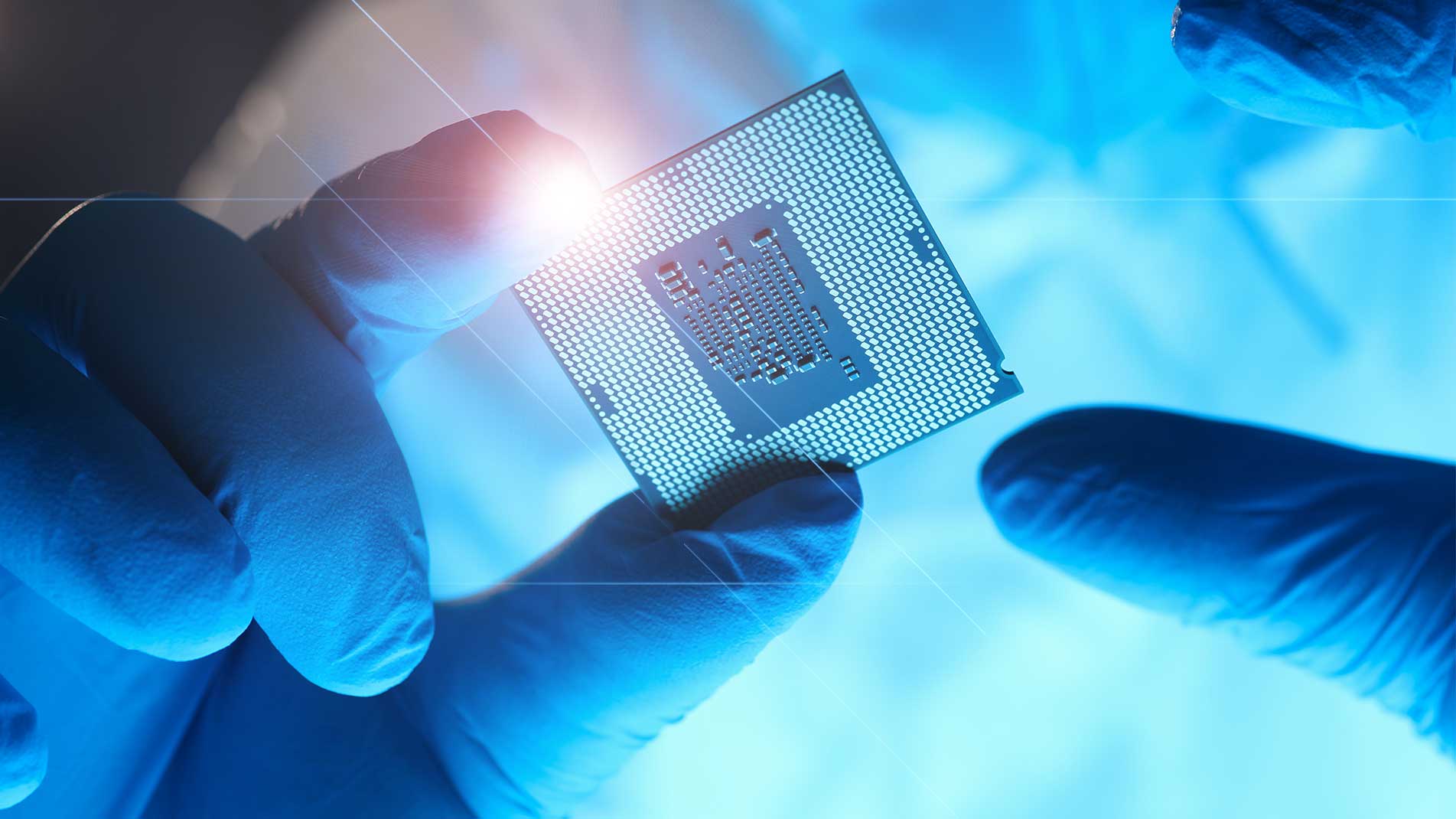
在研发阶段取得试产品芯片后,大多必须透过封装工艺,才能进行后续的工程验证。越来越多客户,特别是学术研究单位,找上宜特进行工程验证时,会先寻求宜特协助进行工程样品快速芯片封装…

芯片结构内部有问题,想要进行切片观察,方式好几种,该如何针对样品属性,选择正确分析手法呢?有传统Grinding;透过机械手法Polish至所需观察的Layer位置;透过Ion Beam进行切削;每一种分析手法有那些优势呢? 该如何选择呢…
