发布日期:2024/7/16TEM EDS轻元素
发布单位:iST宜特
一遇到碳、氮、氧等轻元素,TEM/EDS成份分析就失真?原来都是低能量X光吸收效应在捣蛋。了解并克服这一问题,对于提高组件可靠性和成份分析的准确性至关重要。本文将深入探讨这一现象,一解 TEM EDS轻元素 分析失真之谜。
TEM EDS轻元素
随着半导体技术的不断演进,奈米区域成份分析在新工艺开发中的重要性日益凸显。透过透射电子显微镜/能量分散光谱(TEM/EDS)技术,研究人员能够深入鉴定奈米区域的成份讯息。然而,在进行TEM/EDS成份分析时,特别是涉及碳、氮、氧等轻元素时,低能量X光被吸收的效应仍然相当显著,而且被吸收的量会随着试片厚度的变化而改变。
非常恰巧的是,这些轻元素的化合物都是制造半导体组件常用的材料。因此,用TEM/EDS做半导体组件成份定量分析时,如果有碳、氮、氧等任何元素牵涉在内时,不准度将会提升,必须藉由某些特殊的校正技术,才能重新拉回准确度。校正的方法将在下一期的文章中讨论,本文只先介绍轻元素的吸收效应,以便读者对此有更全面的了解,进而为未来的半导体工艺开发提供有力的技术支撑。
TEM EDS轻元素
TEM EDS轻元素
TEM EDS轻元素
一、轻元素EDS简介
EDS成份分析仪可架设于TEM和SEM两种电子显微镜上,本文探讨的成份分析技术专注在TEM/EDS中。关于TEM/EDS和SEM/EDS的差异,我们在上一期文章有稍作介绍(阅读更多:EDS能谱中的伪讯号跟能峰重迭 如何聪明判读)。
做EDS成份分析的人都知道在SEM/EDS系统中,轻元素的X光吸收效应非常显著,所以定量成份分析时,必须使用ZAF法(Z指原子序数/atomic number;A指吸收/absorption;F指荧光性/fluorescence)修正,也就是说在SEM/EDS中,吸收效应非常显著。相对于SEM使用块材当样品,TEM使用薄片(thin foil)型试片,因此很多人认为在TEM/EDS分析中,吸收效应可忽略。在很多材料系统,例如金属材材料,这是事实。
但是从数以百计的TEM/EDS分析案例中,我们发现特别是碳、氮、氧等这些常见于半导体组件中的轻元素,所产生的低能量X光被吸收的效应不但相当显著,而且被吸收的量还会随着试片厚度改变。导致运用TEM/EDS做半导体组件成份定量分析时,如果牵涉到碳、氮、氧等轻元素在内时,材料组成分析结果将失准,这对于半导体新工艺开发,是相当不利的。
图一显示二组含氮化物和氧化物的TEM/ EDS能谱。图一(a)分析区域包含氮化钛(TiN)和二氧化硅(SiO2)二相(如右上角TEM影像的橘色圆圈标示),是半导体组件的基本结构的部分;图一(b)分析区域为氮化镓(GaN) 层(如右上角TEM影像的橘色圆圈标示)。SiO2、TiN、和GaN都是定组成化合物(stoichiometric compounds),二氧化硅中原子数比二个氧原子对一个硅原子;二个氮化物都是一个氮原子对一个金属原子。
理论上,讯号强度和组成元素的浓度成正比,所以氧能峰应该是硅能峰的二倍高,氮能峰应该和钛或镓的能峰一样高,但是在实际的EDS能谱中,氮和氧的能峰都低很多,如图一中二个能谱所示。造成这种结果的机构主要有二,是本文接下来要讨论的主题。
二、EDS侦测器灵敏度曲线
首先,是EDS侦测器本身特性的问题。EDS侦测器对各能量的X光的侦测灵敏度并不相同,从0 ~ 30 KeV的EDS侦测器灵敏度曲线如图二(a)所示[1],在3.0 ~ 19.0 KeV之间侦测灵敏度为1;低于3.0 KeV的低能量区,EDS侦测器的侦测灵敏度随能量降低迅速下降至零,图二(b)是低能量区域的放大图[1];在高于19.0 KeV的高能量区域,EDS侦测器的侦测灵敏度也会随能量增加而缓缓下降。侦测灵敏度降低的机构在低能量区和高能量区不同,当X光的能量过高时,会直接穿透侦测晶体而没有产生电子-电洞对,导致侦测灵敏度下降;侦测灵敏度在低能量区下降的机构则是源自侦测器组件结构的衰减。
在侦测晶体前缘有三层结构会衰减低能量的X光,X光能量愈低,被衰减的量愈多,最后被完全阻绝进入侦测晶体。此三层结构分别为真空隔绝窗、金电极、失效层(dead layer),标示在图二(c)的侦测器简易结构剖面示意图内。
这三层结构中,最主要的衰减层是真空隔绝窗。最早期的真空隔绝窗材料使用厚度7 ~ 12微米的金属铍(Be),此种EDS侦测器很耐用,但是无法侦测氧(含)以下的元素,改良成高分子超薄窗后,EDS可以侦测到碳,用无窗式的EDS侦测器则可侦测到硼(B)。虽然2010年后,EDS侦测器的效能和性能有大幅度的提升,也逐渐用硅漂移侦测器(Silicon Drift Detector, SDD)取代锂漂移侦测器(Lithium-drifted silicon detector, Si(Li)D),再搭配无窗模式,对氧的灵敏度提高2.5倍以上[3],但是在低能量区侦测灵敏度迅速下滑的趋势仍然维持不变。
EDS能谱最后呈现的元素能峰高度是所有进入EDS侦测器的X光,和EDS侦测器的灵敏度曲线卷积(convolution)的结果。图三简易说明卷积运算的概念,图三(a)中蓝色虚线的能峰代表理想状态下氧化铝(Al2O3)被电子束激发后产生的X光的强度,氧能峰的高度是铝能峰的高度的1.5倍;橘色曲线是EDS灵敏度曲线。二者卷积后形成图三(b)中的实际EDS能谱,氧能峰高度不到铝能峰高度的一半。
因此定量分析推算二者的真正浓度时,必须先用元素的能峰强度(peak intensity)或能峰积分强度(integrated intensity)除以该元素的灵敏系数。由于氧的灵敏系数远小于1,所以些微的氧讯号强度变化,就会导致数据显著的波动,增大运算结果的不准度。
三、X光吸收
第二个使氧和氮的能峰高度偏低的机构是吸收效应。在试片内产生的X光,必须先能够逸出试片,才有机会进入EDS侦测器。X光在试片内行进时,X光的能量愈小,路径愈长,逸出试片的机率就愈低,消失在试片内的X光称之为被试片吸收,如图4(a)所示,图中箭头的宽度代表讯号的强度,蓝色箭头代表高能量(> 1 KeV)的X光,橘色代表低能量(< 0.6 KeV)的X光。高能量X光能全部逸出试片,而低能量X光只有一部分能够逸出试片。
从长期累积的TEM/EDS分析经验发现,对于TEM试片而言,当X光的能量低于0.6 KeV时,被吸收的效应就逐渐明显,而且试片厚度愈大,吸收的效应就愈明显。另外,从试片的原子释出的X光的行进路径是任意的,当X光的行进路径和试片表面的夹角愈小时,它要离开试片的路径就愈长,如图4(b)所示,被吸收的机率就愈高。所以高角度型的EDS侦测器对轻元素有较佳的灵敏度。
相对于手工研磨抛光的TEM试片呈楔形,FIB制备的TEM试片一向被认为是等厚度。但是由于屏障效应的缘故,没有特别倾转角度修饰的话,FIB制备的TEM试片的厚度通常还是会逐渐往下增加。此厚度的增加幅度对TEM明场影像没有影响,对HRTEM影像的影响也不显著,但是对低能量X光的吸收却有明显的效果。图五显示一组InGaN/AlGaN/GaN多重量子阱的STEM/EDS分析结果,其中镓、铝、铟三者的元素映像图的亮度全图一致,代表在此分析区域内,这些元素被侦测到的X光强度一致,但是氮元素映像图的亮度却是逐渐往下降低,显示EDS侦测器侦测到的氮含量逐渐往下变少。
从此能谱影像萃取出的EDS直线浓度变化图(图六)更清楚显示此变化情形。样品供应者确定在MOCVD工艺中没有改变氮和镓的比例[4],所以图六中氮的浓度逐渐变小的原因应该源自吸收效应。当TEM试片厚度逐渐变厚,只有0.392 KeV的氮 K轨域 X光无法逸出试片的量愈来愈高,导致原子百分比下降。
为进一步确认图6中氮浓度逐渐变小的原因,是来自TEM试片厚度逐渐变厚,以致吸收效应逐渐变大所致。我们沿水平方向(等厚度方向)拉取130 nm (同垂直方向的距离)的EDS直线浓度变化图,得到如图七所示的结果,二个位置的氮和镓的比例虽然略有不同,但同一水平位置的比例都保持固定。由此确认TEM试片的厚度变化,确实会影响低能量X光的吸收情况。
TEM/EDS分析可鉴定奈米区域的成份讯息,是目前奈米半导体组件的主要成份分析技术,提供半导体新工艺开发重要的材料组成讯息。TEM/EDS分析型式有二大类型,定性分析和定量分析。前者检测出分析区域有那些组成元素,以及大致相对含量的多寡,是目前EDS分析最常进行的工作。后者则进一步分析这些组成元素的比例到一定的准确度,从被分析物质的组成确认化合物种类,或合金组成。当讯号强度足够时,例如: 最高能峰强度大于2000时,TEM/EDS定量分析的准确度可达到2%。但是,当被分析的材料含有碳、氮、氧等轻元素时,由于EDS侦测器灵敏度和吸收效应二因素,组成准确度很容易劣化到5 ~ 10 %。
如果被分析的区域附近,有可以参考的定组成材料或薄膜层,透过将这些参考材料的组成元素比例当成标准,执行系统性的校正,可以将准确度优化至5%或2%以内。这种系统性校正技术将在宜特材料讲堂下一期文章中讨论。
宜特材料分析实验室在半导体工艺、先进封装领域上耕耘已久,有相当丰富的经验与成功案例。本文与长久支持宜特的您分享,若有相关需求,或是对相关知识想要更进一步了解,欢迎洽询 marketing_tw@istgroup.com。
参考文献:
[1] David B. Williams and C. Barry Carter, in Transmission Electron Microscopy, Microscopy, part IV, Plenum Press, New York (2007). ISBN: 0-471-122440-0
[2] R. E. Lee, Scanning Electron Microscopy and X-Ray Microanalysis, pp. 329-406, PTR Prentice Hall, Englewood Cliffs, New Jersey (1993). ISBN: 0-13-8137590-5
[3] FEI DM (2012)
[4] T. U. Wang, W. C. Lai, S. Y. Sie, S. P. Chang, C. H. Kuo, J. K. Sheu J. S. Bow, “AlGaN-based Deep Ultraviolet Light-emitting Diodes with Thermally Oxidized AlxGa2-xO3 Sidewall,” J. ACS Omega, (2022) .



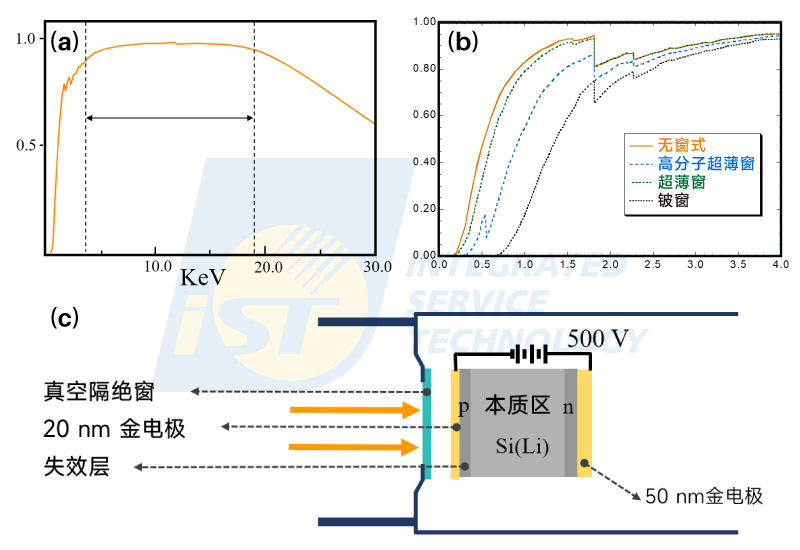

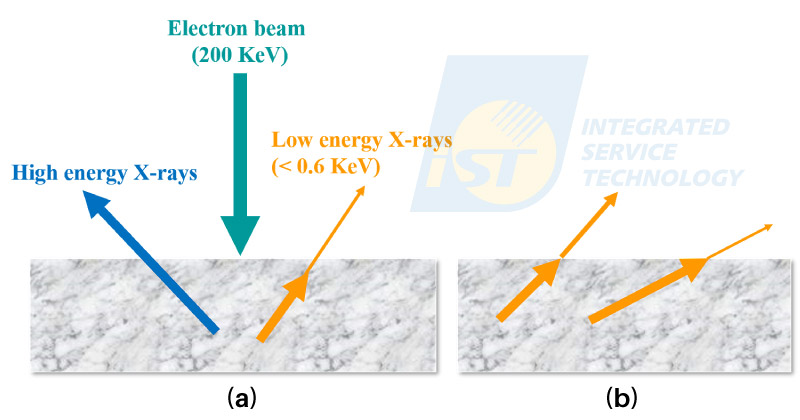
![TEM EDS轻元素 从此能谱影像萃取出的EDS直线浓度变化图(图6)更清楚显示此变化情形。样品供应者确定在MOCVD工艺中没有改变氮和镓的比例[4],所以图6中氮的浓度逐渐变小的原因应该源自吸收效应。当TEM试片厚度逐渐变厚,只有0.392 KeV的氮 K轨域 X光无法逸出试片的量愈来愈高,导致原子百分比下降。](https://cn.istgroup.com/wp-content/uploads/2024/07/tech_20240716-05-TEM-EDS.jpg)

