发布日期:2025/03/18 TEM EDS 自我校正
发布单位:iST宜特
无标准片定量法虽简化流程,但轻元素因吸收效应易产生误差。本文介绍自我校正技术,透过参考相修正EDS数据,大幅提升氧化物、氮化物等分析的准确度,并以GaN薄膜案例验证其应用成效。
随着半导体技术的不断突破,新型材料与工艺的开发需求日益增长,特别是第三类及第四类半导体材料的应用更是驱动功率半导体产业发展的关键。在前一期的材料讲堂文章中(阅读更多:TEM EDS分析失准?原来是轻元素吸收效应在作怪),我们探讨了在进行TEM/EDS成分分析时,涉及碳、氮、氧等轻元素时,低能量X光吸收效应的挑战。这些效应会因试片厚度而变化,进而影响分析准确度。
非常恰巧的是,这些轻元素的化合物正是制造半导体组件的常用材料。因此,当TEM/EDS分析涉及这些元素时,若无特殊校正技术,成分分析的准确性将难以保证。上一期文章对轻元素吸收效应进行了初步介绍,而本篇文章将延续此主题,进一步分享如何利用校正技术来提升分析精度,从而满足现代半导体工艺与新材料研究的严苛需求。
TEM EDS 自我校正
TEM EDS 自我校正
一、EDS定量分析与自我调整简介
TEM/EDS分析型式分为二大类型,定性分析和定量分析。定性分析检测出在分析区域有那些组成元素,以及大致的相对含量,是目前EDS分析最常进行的工作。定量分析则进一步分析这些组成元素的比例到一定的准确度,从被分析物质的组成确认化合物种类,或合金组成。在较旧的教科书和论文中,提到TEM/EDS定量分析,都需要一标准试片,在相同的电子显微镜操作条件下收集讯号,然后再比对运算,计算出测试样品的组成。
TEM使用薄片形式的试片,原则上忽略吸收效应和荧光效应,只考虑原子序效应[1]。近十几年来,EDS仪器设备制造商收集大量EDS分析数据后,依据Cliff和Lorimer[2]提出的模型,在其开发的EDS控制与分析软件中,建立一组以硅为比对基础的K因子(K factors),发展出一套无标准片的定量分析方法(standardless quantitative analysis)。使用无标准片定量分析方法既可免去购买标准试片的繁杂程序和不少的费用,计算出来的结果也相当准确,十几年前就已经广泛被采用,而且全球知名级期刊都已接受这种定量分析结果[3]。
自然界中,雁群在南迁和北归时的迁徙会自动排列成人字形飞行,如图一(a)所示。半导体组件MOS结构在源极、汲极、多晶硅闸极等处形成金属硅化合物时,不需要用任何光罩,全面镀上金属薄膜后,即会在前述三个位置自动形成金属硅化合物,如图一(b)所示。将奈米颗粒放在适量的液体时,这些奈米颗粒会自动排列成形,如图一(c)所示。这些例子指出,自然界和物理领域中都存在许多自我调整的行为,亟待我们探索。从诸多的TEM分析案例中,个人发现在TEM/EDS成份定量分析中,也有可以自我校正的材料系统。
不同厂牌的EDS分析软件中的K因子会略有不同,对于原子序大于等于11的元素,因为其对应的X光能量大于1.0 KeV,差异不大;但是对于X光能量小于0.6 KeV的碳、氮、氧等轻元素时,由于吸收效应的影响,差异值会变大,也就是说成份定量分析的误差变大。凑巧的是,氧化物、氮化物和碳化物是第一类、第三类和第四类半导体组件中的重要材料,用TEM/EDS分析这些材料,尤其是微奈米区域时,都会有不准度的问题。分析过程中,如果能藉由自我校正定量分析法的修正,可以大幅提升氧化物、氮化物和碳化物的TEM/ESD定量分析的准确度。
二、自我校正TEM/ESD定量分析法模型
根据材料显微结构形貌的特性,将材料分成二大类型讨论。第一类型材料系统(材料系统A)的待分析微区呈任意分布状态,第一类型材料系统(材料系统B)的待分析微区呈薄膜层状分布状态。
(一)材料系统A
假设取用x公克A元素和y公克B元素镕炼成一单相的二元合金,则该合金的重量百分比分别为CA = [x/(x+y)] x 100%和CB = [y/(x+y)] x 100%,CA+ CB = 1。将该合金施以适当的热处理后,合金从单相共析成α和β二相,α相和β相都含有A和B二元素,但含量不同。图二显示一简单的材料微结构模型示意图。在相同的(S)TEM操作条件下,用相同的讯号收集时间,从一包含数十个α晶粒和数十个β晶粒的微区取得的EDS能谱,元素A和元素B的讯号强度为IAo和IBo;从α晶粒取得的EDS能谱,元素A和元素B的讯号强度为IAα和IBα;从β晶粒取得的EDS能谱,元素A和元素B的讯号强度为IAβ和IBβ。
图二:某二元素定组成金属材料系统示意图。(a) 刚熔炼后,合金融合成一单相材料;(b) 经适当的热处理,共析成α和β二相。(图片来源:iST)
此例中,因为样品的平均组成已知,可以当作标准样品,α相和β相的组成可以从以下的简单地式子推算出来。
CAα = [IAα / IAo] x CA
CBα = [IBα / IBo] x CB
CAβ = [IAβ / IAo] x CA
CBβ = [IBβ / IBo] x CB笔者曾于1992年用此方法,为指导教授分析一三元系超合金的α相和β相晶粒。计算结果和当时该材料系统唯一一篇论文发表的组成,相差不到2 at%。共析材料和高熵合金材料的微区EDS成份定量分析可采用此模式。
(二)材料系统B
图三显示一多层薄膜材料系统示意图,许多半导体组件结构属于此类行材料系统。如果有一或二种元素共同存在于其中几层,而且有1 或 2层薄膜是定组成化合物,则可以用这1 或 2层薄膜当作标准样品,校正其他层次的组成。首先,用STEM/EDS摄取一组能谱影像[4],先用内建的软件处理和运算,然后从运算后的能谱影像萃取直线成份分布图。如果定组成薄膜的元素比例不正确,将该薄膜的轻元素乘以一大于1的常数,使元素间的比例符合其化学式,所有含此轻元素的薄膜的组成将随着更动。下一章节将用一个实例证明此方法的可行性。
三、GaN/GaOx/SiO2薄膜材料系统
此案例分析结果发表在IPFA 2022论文[5],也曾在2023年的小学堂小品文(阅读更多:第四类半导体来了 如何鉴定Ga2O3氧化镓)中略做讨论[6]。本文中将进一步讨论如何修正TEM内建EDS处理软件计算后的结果。图四(a)为一横截面样品的STEM 明场影像,此样品为氮化镓组件先在氧化气氛环境中高温热处理,冷却后,再用磁控溅镀法(Magnetron of sputtering)在其表面镀上一层二氧化硅薄膜。图四(a)显示氮化镓经高温热处理后,表面生长二层反应物,IA和IB。图四(b) ~ 4(e)分别为镓(Ga)、氮(N)、氧(O)和 硅(Si)的EDS成份映像图。EDS成份映像图显示这二层反应物的组成元素都是镓和氧。图五(a)为对应图四(a) 的高角度环场暗场(HAADF)影像,图中黄色虚线箭头标示出直线成份分布图的轨迹。
图五(b) 直线成份分布图是经由TEM内建的EDS 控制与处理软件,接受EDS讯号后计算出来的结果。EDS分析结果显示反应物IA和IB的组成元素都是镓和氧,而且镓和氧的组成比例非常相近。在图五(b)直线成份分布图中,选择一平坦的区域(如红色虚线矩形标示的位置)推算此反应物的原子百分比为O : Ga = 1.23 : 1.00,根据此比例,反应物的化学式为Ga5O6。从网络搜寻软件中搜寻不到此种组成的化合物。
前期的宜特材料讲堂文章(阅读更多:TEM EDS分析失准?原来是轻元素吸收效应在作怪)中提到,氮和氧的X-光在逸出试片的过程中会有部份被吸收,因此被EDS侦测器侦测到的量通常会低于试片中真正产生的量。仔细查看图5(b)二侧,左侧二氧化硅(SiO2)的氧的原子百分比不到硅的二倍;右侧氮化镓(GaN)的氮原子百分比也明显低于镓。TEM内建的EDS处理软件只能根据侦测到的讯号量计算结果,无法推断吸收效应的大小。所以,如果不假思索,直接接受这个计算结果,将会产生很大的材料分析错误。
将图5(b)的氧的原子百分比提高到硅的二倍,氮的原子百分比提高到和镓等量,重新计算原子百分比,得到图5(c)的结果。从图5(c)直线成份分布图中平坦的区域(同图5(b))再次推算反应物的原子百分比为O : Ga = 1:53 : 1.00。根据此比例,反应物的化学式为Ga2O3,是氧化镓最稳定相的组成[7],也号称是第四代(类)半导体材料。
此薄膜材料系统中,未知成份的薄膜二侧恰好有二层定组成的薄膜,透过修正定组成薄膜的EDS数据,可以更准确地定量分析未知成份薄膜的组成。这种藉由已知成份的邻近相,更准确地分析待分析相的技术是自我校正TEM/ESD定量分析法的关键所在。
准确的TEM/EDS定量分析是微奈米成份分析追求的目标。古典的EDS定量分析需要标准试片,近代藉由K因子建立的无标准定量分析法(standardless quantitative analysis)舍去标准试片的制作,改用以硅为比对标准的K因子技术,已成为TEM/EDS定量分析的主流技术。只是K因子无标准定量分析法无法将轻元素在不同试片间的吸收效应差异并入计算。在待测物的周围引入含有相关元素且已知比例的定组成相,可以藉由修正已知相的元素比例,精确地分析待测物的组成。
由于作为标准的参考相和待测物都在同一TEM试片,机台的操作参数完全相同,有益于进行自我校正TEM/ESD定量分析法,更准确地分析出待测物的成份。此分析技术最重要的关键是如何将可以做为标准的参考相和待测物同时并在同一TEM试片中。因为此种限制,自我校正TEM/ESD定量分析法目前只能用在部分材料系统中,尚无法应用在所有材料系统。
致谢:
本文所使用的氮化镓试片为成功大学光电系所赖韦志教授提供,仅在此致谢。
参考文献 (references):
[1] D. B. Williams and C. B. Carter, in Transmission Electron Microscopy, Chapter 35, (2009).
[2] G. Cliff and G. W. Lorimer, The quantitative analysis of thin specimens, J. Microscopy, 103[2], p.203-207 (1975)
[3] J. H. Paterson, J. N. Chapman, W. A. P. Nicholson, and J. M. Titchmarsh, “Characteristic X-ray production cross-sections for standardless elemental analysis in EDX”, J. Microscopy 154, 1-17 (1989).
[4] Dale E. Newbury and David S. Bright,“Derived Spectra” Software Tools for Detecting Spatial and Spectral Features in Spectrum Images, Scanning vol. 27, 15–22 (2005).
[5] Jong-Shing Bow, Jay Wang, Wei-Chih Lai , Tien-Yu Wang, Syuan-Yu Sie, Sheng-Po Chang, Cheng-Huang Kuo, Jinn-Kong Sheu, Characterization of Oxide Layers on AlGaN Based DUV LEDs by TEM/STEM Analysis, IPFA 2022, 155 (2022).
[6] 鲍忠兴,第四代半导体来了 如何鉴定 Ga2O3 氧化镓,宜特小学堂,(2023).
[7] T. Oshima, T. Okuno, N. Arai et al., “Vertical sola-blind deep-ultraviolet Schottky photodetectors based on b- Ga2O3 substrates,” Appl. Phy. Express, 1(1):011202 (2008)


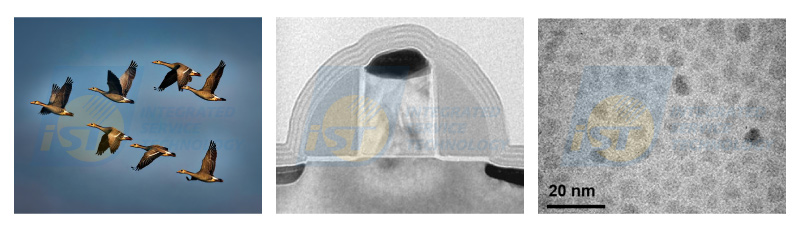
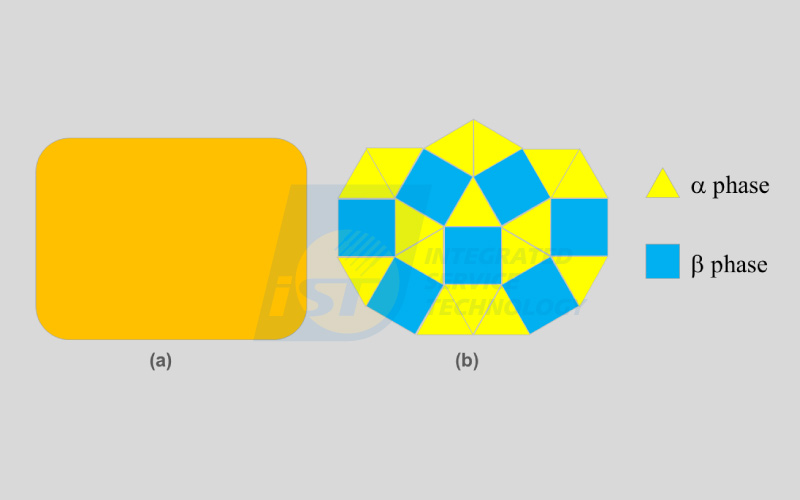
![TEM EDS 自我校正 图3显示一多层薄膜材料系统示意图,许多半导体组件结构属于此类行材料系统。如果有一或二种元素共同存在于其中几层,而且有1 或 2层薄膜是定组成化合物,则可以用这1 或 2层薄膜当作标准样品,校正其他层次的组成。首先,用STEM/EDS摄取一组能谱影像[4],先用内建的软件处理和运算,然后从运算后的能谱影像萃取直线成份分布图。如果定组成薄膜的元素比例不正确,将该薄膜的轻元素乘以一大于1的常数,使元素间的比例符合其化学式,所有含此轻元素的薄膜的组成将随着更动。下一章节将用一个实例证明此方法的可行性。](https://cn.istgroup.com/wp-content/uploads/2025/03/tech_20250318-TEM-EDS-Calibration-03.jpg)