发布日期:2023/1/10第四代半导体,
发布单位:iST宜特
以Ga2O3氧化镓为主的 第四代半导体 跃上台面,将成为下一个明日之星,如何鉴定呢?
用氮化铝镓(AlGaN)磊晶为主要材料制造的深紫外光(deep ultraviolet, DUV)发光二极管(light-emitting diodes, LEDs)组件,其优异的光学性质和体积小的特性,逐渐取代水银灯和氙气灯,成为携带型生化检查系统、净水器、紫外光微影曝光机等的光源[1-3]。藉由各种改善磊晶层结构质量的方法,可以进一步增进现阶段氮化铝镓(AlGaN)深紫外光发光二极管的光学性质[4, 5]。其中一个方法是在氮化镓(GaN)和氮化铝镓(AlGaN)的侧壁上引入一层奈米级氧化镓(Ga2O3)磊晶层[6]。
本期宜特小学堂,将呈现如何应用宜特材料分析实验室的穿透式电子显微镜(TEM)分析技术鉴定俗称第四代半导体-氧化镓(Ga2O3)磊晶层的晶体结构,晶体形貌与组成。
第四代半导体
第四代半导体
氧化镓(Ga2O3)被称为第四代半导体的原因是,其超宽能隙的特性,相较于相较于第三代半导体(化合物半导体)碳化硅(SiC)与氮化镓(GaN),将使材料能承受更高电压的崩溃电压与临界电场。
一、 氮化铝镓深紫外光发光二极管组件结构
用有机金属化学气相沉积(Metal-organic Chemical Vapor Deposition, MOCVD),制作的氮化铝镓深紫外光发光二极管薄膜组件之剖面图如图一(a)所示。先在蓝宝石(sapphire)基板上长一层氮化铝(aluminum nitride, AlN)做为缓冲层,减少后续氮化铝镓磊晶层的差排缺陷,长上二层不同铝浓度的氮化铝镓磊晶层后,再长上多重量子阱(multiple quantum well, MQW)层、电子阻挡层(electron-blocking layer, EBL)、氮化镓(gallium nitride, GaN)等奈米磊晶层。
接下来用微影制程将此MOCVD制作的组件顶部蚀刻成如图一(b)所示的平台形状,然后在氧化气氛的高温中热处理,使氮化铝镓磊晶层侧壁和氮化镓表面生成氧化物,最后再用磁控溅镀(magnetron sputtering)法镀上一层100奈米厚的高纯度二氧化硅[7],如图1一(c)所示。
二、 TEM影像与电子绕射分析鉴定反应生成相
先用聚焦离子束(focus ion beam, FIB)在组件顶部选定的位置切割,制成横截面型TEM (cross-section TEM, X-TEM)试片[8],然后对一系列不同热处理的氮化铝镓试片进行TEM/STEM影像分析和电子绕射,目的在鉴定氮化铝镓磊晶层侧壁和氮化镓表面形成的氧化物为何物。
图2显示二张中低倍率的TEM明场像,分别为原始氮化铝镓试片与900℃,20分钟热处理的氮化铝镓试片的横截面结构。仔细比较图2a与图2b,可以发现热处理后的试片,在氮化镓层顶部和氮化铝镓层侧壁共有三个新相(phases)产生,如图2b中标示1、2、3的区域。
图3中比较900℃,20分钟热处理的氮化铝镓试片的STEM明场像和环形暗场像。综合图2和图3中的TEM与STEM影像,宜特材料分析实验室初步归纳出STEM环形暗场像是此材料系统的最佳影像分析技术。我们在将影像倍率再往上提高,进一步确认STEM暗场像在此材料系统的适宜性。
如图4所示,STEM环形暗场像,明显比STEM明场像更清楚区分各新形成的生成物。从以上这些初步的影像数据中,生成物影像明暗对比的变化特性,推断第一相和第三相为多晶,且晶粒大小只有数奈米,而第二相有可能为单晶结构。
图四:二组中高倍率STEM影像显示900℃/20 min,热处理后二极管组件顶部与侧壁的氧化层结构。(a)&(b)分别为GaN顶部与侧壁的氧化层结构的STEM明场像和环形暗场像;(c)&(d)分别为AlGaN侧壁的氧化层结构STEM明场像和环形暗场像。
图五则显示一组选区绕射图案(selected area diffraction pattern, SADP)和一低倍率STEM明场像。这些SADPs分别对应氮化镓层、氮化铝镓层、和三个生成物(图5a)。氮化镓层和氮化铝镓层都是磊晶层(epitaxial layer),对应的SADPs指出TEM观察方向都是[1 1 -2 0]极轴(zone axis)方向。三个生成物的SADPs目前尚未完全解出,但是其形貌都是单一组点状绕射图案,而且非常类似。此种形式的SADPs指出该分析区域是单晶,而且这些单晶的某个晶向都和氮化镓层(氮化铝镓层)的[0002]晶向逆时针偏转约10度。这个从SADPs的晶体分析结果和从图三与图四影像数据推论的晶体结果有所矛盾。
图五: 900℃/20分钟热处理后,氮化铝镓试片的低倍率STEM明场像,与磊晶层的选区绕射图案。(a)低倍率STEM明场像;(b)GaN的SADP,z = [11 -2 0];(c) AlGaN的SADP,z = [11 -2 0];(d)第1相生成物的SADP;(e)第2相生成物的SADP;(f)第3相生成的SADP。
(图片来源:成功大学赖韦志教授)。针对前述TEM/STEM分析结果的矛盾,我们进行临场TEM/STEM影像和电子绕射交互分析观察,确定在氮化镓层上方/侧壁和氮化铝镓侧壁,经高温热处理后产生的生成物都是单晶。第一相生成物和第三相生成物内的明暗变化,并非因为晶粒产生的绕射对比,而是试片本身密度变化产生的原子序对比。
从更高倍率的STEM环形暗场像,如图六所示,我们更清楚辨认生成物为多孔性结构,暗色的区域(明场像中亮的区域)是空孔。第一相生成物空孔的尺寸明显数倍大于第三相生成物空孔的尺寸,第二相生成物算是致密的单晶结构,但其内仍有几个大空孔,其中一个如图六中白色箭头指处。造成第一相生成物和第三相生成物为多孔性结构的原因,推测可能是热处理温度过高,氧和镓与铝的交互扩散速率高于生成物原子堆积速率所导致的结果。
一般来说,用电子绕射图案解析晶体结构,必须从数个极轴方向的SASPs推算才能得到确定的结果。由于目前只有一个极轴方向的SASPs,很难从这些有限的SADPs中明确地推算出生成物的晶体结构。从SASP模拟分析中发现β-Ga2O3的[0 1 0] SADP和图五(d, e, f)中的SADP很接近,因此初步推断在GaN层上的生成物有可能是β-Ga2O3,而在AlGaN层上的生成物则有可能是β-(AlxGa1-x)2O3。由于β-Ga2O3是单斜晶体,其SADP的分析工作将会复杂许多。
三、 STEM/EDS分析-自我校正定量分析
图七显示一组由STEM/EDS能谱影像(spectrum image)技术,获得的氮化镓和生成物之元素映像图(elemental maps)。这些元素映像图显示生成物的组成元素只有氧和镓,意指此生成物是镓氧化物。再用EDS软件从二氧化硅层拉一垂直相界(phase boundary)的直线(图八(a)中的浅蓝色箭头),通过氧化物到达氮化镓层,算出沿此直线各元素的浓度变化。
图八(b)显示计算出来的结果,此计算结果是由TEM的EDS软件用内存的K因子(K factors) [9-11],进行成份定量分析。这样EDS定量分析方法称为无标准试片定量分析法(standardless quantitative analysis),此方法计算的结果目前已广泛被各种科学与工程类的论文期刊接受。
在图八(b)的EDS直线浓度变化曲线(line profiles)内,对应氧化物1B的区段内,找出一平坦的区段,推算氧化物1B的成份,得到该氧化物的组成元素比(O/Ga)为1.23,相当于化学式为Ga5O6。这是EDS侦测器接收从试片发出的元素X-光讯号,加上数据库内的K因子后计算出的氧化物成分,然而文献中没有这种成份的氧化镓。
当定量分析的元素包含碳、氮、氧等轻元素时,即使TEM试片属薄片(thin foil)型试片,吸收效应仍然相当显著,只是经常被忽略,造成相当大的误差而不知觉。仔细检查图八(b)可以发现,在直线浓度变化曲线的左侧二氧化硅区段中O/Si比值小于2,而右侧氮化镓区段中N/Ga比值明显小于1。利用这二侧已知成份的二氧化硅层和氮化镓层,对此直线浓度变化曲线做自我校正(self-calibration)修正。
经修正后的直线浓度变化曲线如图八(c)所示,此时从相同平坦区段推算的组成元素比(O/Ga)为1.53,相当于化学式为Ga2O3,符合文献中报导的氧化镓组成[12],也符合化学键价数的搭配。
在TEM(STEM) /EDS成份定量分析中,利用待分析物周围已知成份的相,做自我校正计算,进一步提高EDS定量分析的准确度称为「EDS自我校正定量分析法(self-calibration EDS quantitative analysis)」,此技术是宜特实验室自行开发的TEM材料成份分析技术之一,校正后的结果比只经由EDS内建软件的计算结果准确许多。
主要的原因在于所有的TEM/EDS内建软件都不考虑元素X-光在TEM试片内的吸收效应。然而当EDS定量分析牵涉到碳、氮、氧等轻元素时,因这些元素的X-光能量很小,吸收效应产生的误差就变成相当明显。对于含轻元素的化合物,透过EDS自我校正定量分析法,宜特材料分析实验室的TEM/EDS定量分析结果比其他TEM分析实验室更为准确。
图七: 900℃/20 分钟热处理试片的氮化镓和氧化物的元素映像图。(a)分析区域的STEM BF影像;(b)镓元素映像图;(c)氮元素映像图;(d)氧元素映像图;(e)硅元素映像图;(f)综合元素映像图。[8]
本文与各位长久以来支持宜特的您分享,若您有相关需求,或是对相关知识想要更进一步了解细节,欢迎洽询 +886-3-579-9909 分机 1016 鲍博士 / Email: Js_Bow@istgroup.com;marketing_tw@istgroup.com
参考文献:
[1] H. Hirayama, T. Yatabe, N. Noguchi, N. Kamata, “Development of 230-270 nm AlGaN-Based Deep-UV LEDs,” Electron. Commun. Jpn., 93 (3), 24–33 (2010).
[2] M. Martens, F. Mehnke, C. Kuhn, C. Reich, V. Kueller, A. Knauer, C. Netzel, C. Hartmann, J. Wollweber, J. Rass, T. Wernicke, M. Bickermann, M. Weyers, M. Kneissl, “Performance Characteristics of UV-C AlGaN-Based Lasers Grown on Sapphire and Bulk AlN Substrates,” IEEE Photonics Technol. Lett., 26 (4), 342–345 (2014).
[3] F. Mehnke, M. Guttmann, J. Enslin, Kuhn, C. C. Reich, J. Jordan, S. Kapanke, A. Knauer, M. Lapeyrade, U. Zeimer, H. Krüger, M. Rabe, S. Einfeldt, T. Wernicke, H. Ewald, M. Weyers, M.Kneissl, “Gas Sensing of Nitrogen Oxide Utilizing Spectrally Pure Deep UV LEDs,” IEEE J. Sel. Top. Quantum Electron., 23 (2), 29–36 (2017).
[4] S. M. Islam, V. Protasenko, K. Lee, S. Rouvimov, J. Verma, H. Xing, D. Jena, “DUV Emission at 219 nm from Ultrathin MBE GaN/AlN Quantum Heterostructures,” Appl. Phys. Lett., 111 (9), 091104 (2017).
[5] T. Takano, T. Mino, J. Sakai, N. Noguchi, K. Tsubaki, H. Hirayama, “Deep-Ultraviolet Light-Emitting Diodes with External Quantum Efficiency Higher than 20% at 275 nm Achieved by Improving Light-Extraction Efficiency,” Appl. Phys. Express, 10 (3), 031002 (2017).
[6] T. Y. Wang, W. C. Lai, S. Y. Sie, S. P. Chang, Y. R. Wu, Y. Z. Chiou, C. H. Kuo, J. K. Sheu, “AlGaN-Based Deep Ultraviolet Light Emitting Diodes with Magnesium Delta-Doped AlGaN Last Barrier,” Appl. Phys. Lett., 117 (25), 251101 (2020).
[7] T. U. Wang, W. C. Lai, S. Y. Sie, S. P. Chang, C. H. Kuo, J. K. Sheu J. S. Bow, “AlGaN-based Deep Ultraviolet Light-emitting Diodes with Thermally Oxidized AlxGa2-xO3 Sidewall,” J. ACS Omega, (ACS ID: ao-2022-00813q.R2) (2022).
[8] J. S. Bow, Jay Wang, W. C. Lai , T. Y. Wang, S. Y. Sie, S. P. Chang, C. H. Kuo, J. K. Sheu, “Characterization of Oxide Layers on AlGaN Based DUV LEDs by TEM/STEM Analysis” IPFA 2022 (2022).
[9] G. Cliff and G. W. Lorimer, “The quantitative analysis of thin specimens”, J. Microscopy 103, 203-207 (1975).
[10] J. H. Paterson, J. N. Chapman, W. A. P. Nicholson, and J. M. Titchmarsh, “Characteristic X-ray production cross-sections for standardless elemental analysis in EDX”, J. Microscopy 154, 1-17 (1989).
[11] D. B. Williams and C. B. Carter, in Transmission Electron Microscopy, Chapter 35, (2009)
[12] T. Oshima, T. Okuno, N. Arai et al., “Vertical sola-blind deep-ultraviolet Schottky photodetectors based on β- Ga2O3 substrates,” Appl. Phy. Express, 1(1):011202 (2008).

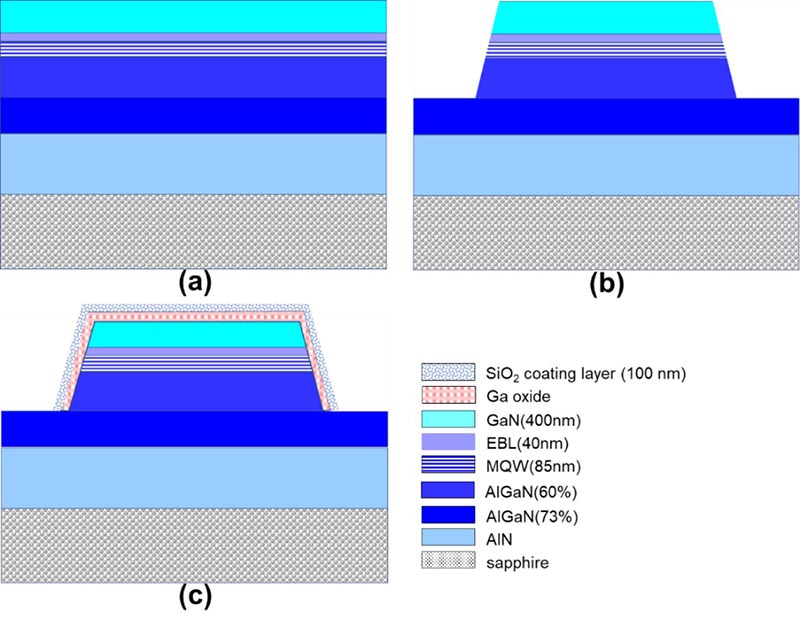
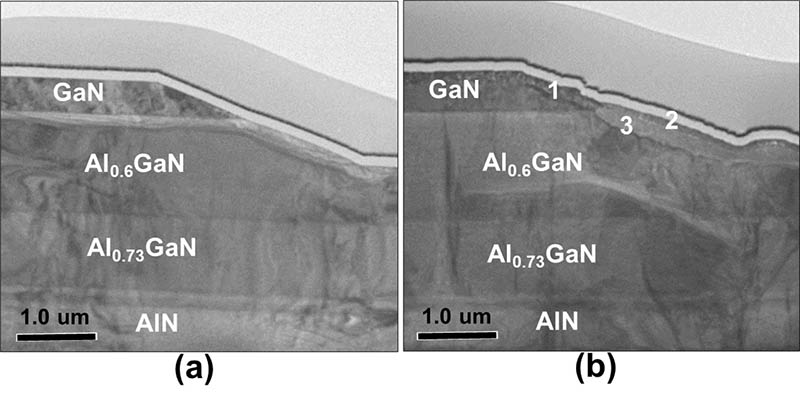
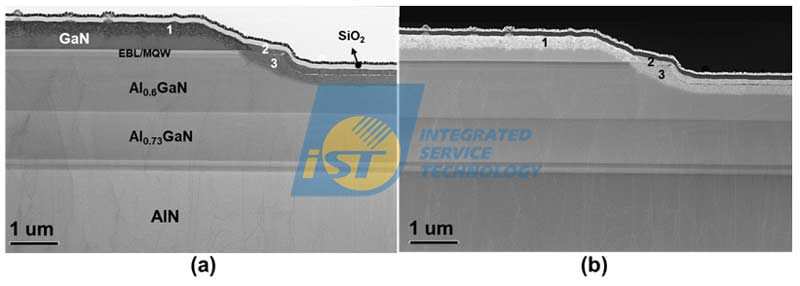
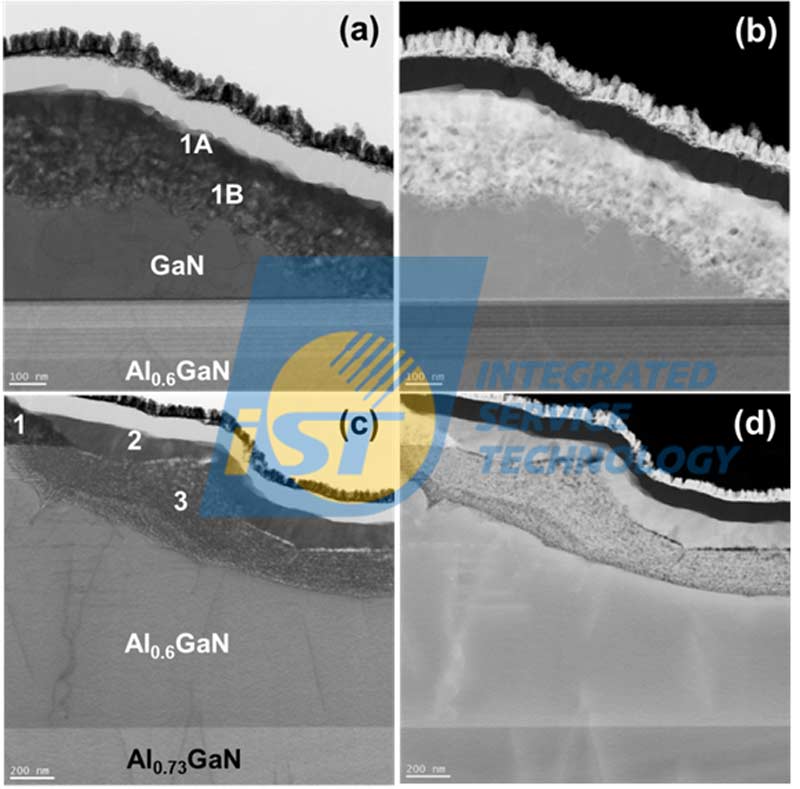
![900℃/20分钟热处理后,氮化铝镓试片的低倍率STEM明场像,与磊晶层的选区绕射图案。(a)低倍率STEM明场像;(b)GaN的SADP,z = [11 -2 0];(c) AlGaN的SADP,z = [11 -2 0];(d)第1相生成物的SADP;(e)第2相生成物的SADP;(f)第3相生成的SADP](https://cn.istgroup.com/wp-content/uploads/2023/01/tech_20230110-05-Ga2O3-1.jpg)