发布日期:2016/7/28
发布单位:iST宜特
IC封装回来,电性测试却异常—
是芯片设计端有问题?还是IC封装端异常?是哪个制程环节出了问题?
PCBA测试结果异常—
是芯片设计端 或者封装端需调整?还是SMT黏着焊点异常,到底该如何厘清?
上述问题,或多或少您都有遇到过。这些问题该如何找出原因,都有一个共通点,必须在不破坏样品的前提下做检测,例如X-Ray。
然而,以往在设备的极限下,包括分辨率不够好、倍率较低,使得上述有些微小的异常点,不容易用X-Ray找到,因而无法短时间厘清问题与改善解决。
您的心声,我们都听到了,因此宜特今年升级设备,引进业界分辨率最好、倍率最高、还可360度拍摄零死角影像环绕的ZEISS Xradia 520 Versa高分辨率三维X光显微镜( High Resolution 3D X-Ray Microscope)设备。
升级之后,除了可以让您轻易找到异常点。更重要的是,能够测试的样品种类与尺寸变多元、变大。除了一般IC、包括3D IC、MEMS,甚至到PCB、PCBA、系统成品,只要尺寸在30公分以内、重量达15公斤以下的产品,不用破坏分割,都可以送来宜特委案。

案例1
案例2
案例3
被动组件失效,样品进行Thermal EMMI确认漏电情形(Leakage)后,再进行3D X-Ray实验检测,发现有金属异物残留现象。
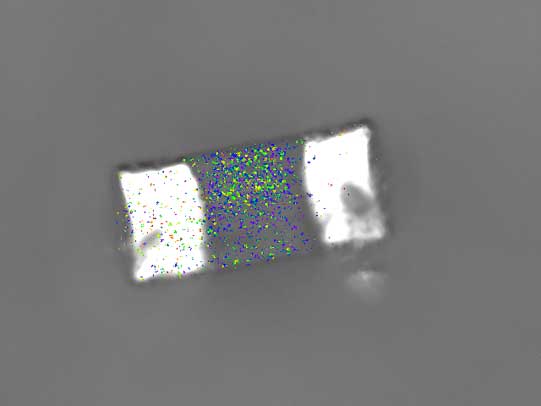
Thermal EMMI热点影像
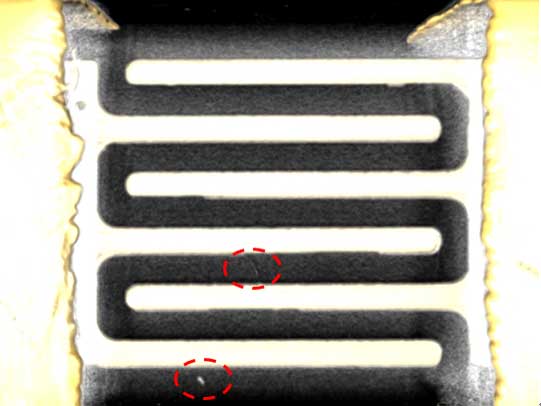
利用3D X-Ray,侦测出金属异物
另外,做完3D X-Ray,若需要更进一步了解异常现象,宜特也提供包括切片、红墨水实验,协助您全面诊断:
PFA(物性故障分析):3D X-Ray定位出异常点后,再进行切片验证。
CRE(零件可靠度):3D X-Ray检测发现小区域有微裂(Crack)现象后,则可进行红墨水试验(Dye/Pry test)确认焊点是否有全面性的微裂。
此外,若您想了解您目前产品所遇到的异常,是否适合使用3D X-Ray来检测,欢迎参见下列应用:
- IC封装中的缺陷检验:打线的完整性检测、电测异常(open/short)、黑胶裂痕、银胶及黑胶气泡。
- 印刷电路板及载板制程中可能产生的缺陷﹕线路制程不良、桥接及开路;电镀孔制程品质检测;多层板各层线路配置分析。
- 电子产品开路、短路或不正常连接的缺陷检验。
- 锡球数组封装、覆芯片封装中锡球的完整性检验:锡球变形、锡裂、锡球空冷焊、锡球短路、锡球气泡。
- 密度较高的塑料材质破裂或金属材质空洞检验。
- 各式主、被动组件检测分析。
- 各种材料结构检验分析及尺寸量测。
本文与各位长久以来支持宜特的您,分享检测验证经验,若您有样品异常现象需要判断检测,或是对相关知识想要更进一步了解细节,不要犹豫,欢迎洽询中国免费咨询电话: 400-928-9287│ Email: marketing_chn@istgroup.com。