发布日期:2017/12/26
发布单位:iST宜特
半导体制程利用离子植入/扩散方式,进行电流大小控制与P/N电性调变,如何精准计算掺入数量与深度?
LED磊晶掺入杂质原子,形成P/N type,如何得知掺入数量?
由于LED/半导体的P型与N型,是藉由掺入的杂质浓度来调整;而随着半导体追逐摩尔定律,在不断向下挑战奈米等级、晶圆/LED制程不断调整之际,控制好半导体制程的参数,以维持组件/磊晶稳定性是首要步骤,倘落未能妥善监控杂质掺入浓度,将有可能影响电流/电阻特性,进而影响IC/LED效能。
本月小学堂,就要和身为晶圆/LED工艺工程师的您分享,得知P/N 离子浓度分布的绝佳利器-二次离子质谱分析技术(SIMS)。
样品通过使用一次离子进行溅射/蚀刻,在溅射过程中形成的二次离子,利用质谱仪来进行分析。主要是利用离子高灵敏度的特性,针对样品的微污染,掺杂与离子植入的定量分析,以及接口扩散行为的研究,均具有高解析的侦测能力。
(一) SIMS常见的问题
任何元素都可以分析吗?
在周期表中所有的元素都可以经由SIMS来进行分析,一般常见半导体制程为分析P型-硼离子(B)、N型-磷(P)与砷(As)等离子;而在LED磊晶上,主要分析P型-镁(Mg)与N型-硅(Si)。
对于大部分元素的最低侦测极限可达ppma(1E-6),甚至对于部份元素的侦测极限高达ppba (1E-9),因此被广泛的应用于半导体以及薄膜材料的微量检测分析上。
SIMS分析可以得到哪些讯息?
iST的SIMS高质量解析力除了可进行掺杂植入量的浓度分析外,还可进行P/N接口的深度分析(Junction Depth),以及BULK材料中微量元素的浓度分析。
分析的样品有何限制?
主要应用为破坏式的分析方式,任何样品包括LED、面板类、太阳能、PCB以及基本的Si晶圆制程均可适用,最适当样品尺寸为10mm.表面须平滑,可以获得较好的分辨率。分析深度可由数十奈米(nm)至数十微米(um)。
(二) 实际分析出的元素图
案例一: 侦测极限ppba level分析
- 分析样品: 半导体硅晶圆
- 以下是宜特测试SIMS机台的最高极限,分析半导体硅晶圆之砷(As)离子植入的浓度,从图可了解,SIMS可判断高达0.2 ppba的侦测极限。
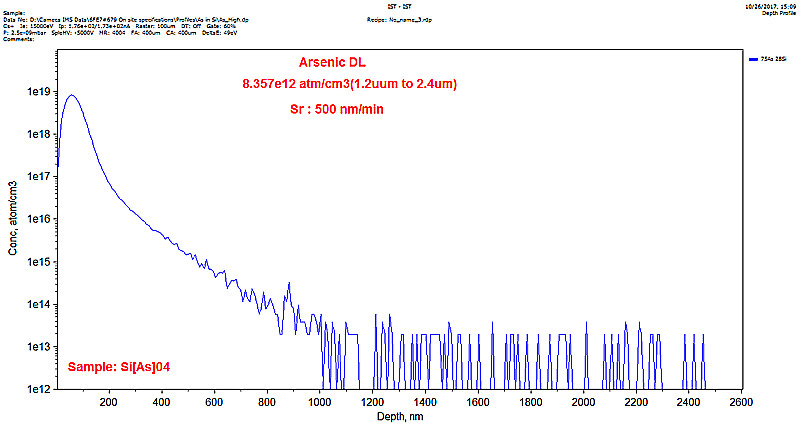
N型 :砷(As)离子植入Si芯片之纵深分布图
案例二:高解析SIMS分析
- 分析样品: 半导体硅晶圆
- 经由多层奈米厚度的硼(B)植入分析,可从中了解SIMS的纵深分辨率。以下是宜特测试SIMS机台的深度分析能耐,藉此特殊的高解析分析技术可从中了解最小的纵深分辨率达1.65nm。

P型: 硼(B) )离子植入Si芯片之纵深分析图
案例三:LED磊晶浓度分析
- 分析样品: LED磊晶
- LED 在SIMS分析中,需要观测的微量元素高达七八种,以下可得知磊晶中镁(Mg, P型)与硅(Si, N型)的浓度分布,并结合TEM分析的影像后,即可得知各元素在磊晶中的相对位置。

上图为: SIMS分析,得知浓度分布 / 下图为: TEM分析,得知元素相对位置
本文与各位长久以来支持宜特的您,分享检测验证经验,若您有样品异常现象需要判断检测,或是对相关知识想要更进一步了解细节,不要犹豫,欢迎洽询中国免费咨询电话: 400-928-9287│ Email: marketing_chn@istgroup.com。

