发布日期:2025/9/9TGV失效分析
发布单位:iST宜特
挑战硅霸权?TGV(Through-Glass Via)玻璃基板技术因优异的高频与低损耗特性,广泛应用于5G、AIoT、车用雷达等领域,成为先进封装的新选项。然而,业界在推动 TGV 技术导入时,却频繁遇到工艺良率、封装机械强度、以及材料热失配 (CTE mismatch)等问题。该如何找出失效真因,提升良率呢?
TGV失效分析
半导体产业正迎来基板材料的重大革新!随着 AI、高速运算(HPC)与电动车等应用日益蓬勃,因低损耗、高频特性与成本优势的需求,利用玻璃基板制作玻璃通孔(TGV, Through-Glass Via)在高阶封装技术发展中逐渐被重视,也成为这股AI变革浪潮中,有机会取代硅基板制作的硅中介层(Silicon Interposer)技术的明日之星。
根据业界报导,Intel、Samsung、Hana Technology、Nippon Electric Glass(NEG)等多家半导体与材料大厂,已纷纷投入TGV 的开发与试产,并针对 AI 芯片、高频模块等应用设计新一代封装架构。根据 Verified Market Reports 的研究,TGV技术市场规模预计将由 2024 年的 12 亿美元提升至 2033 年的 25 亿美元,2026–2033年预测年均复合成长率为 9.5%,显示其具备高度竞争价值。
什么是TGV玻璃基板技术?TGV 是一种于玻璃基板上制作「金属导电孔」(vias)的技术。简单来说,就是在一片玻璃板上钻孔,再把导电金属(如铜)填入孔内,让电信讯号得以从玻璃的一面传输到另一侧。像是在玻璃上开出许多高速信道,让芯片之间的电讯号可以快速且低损耗地传输。
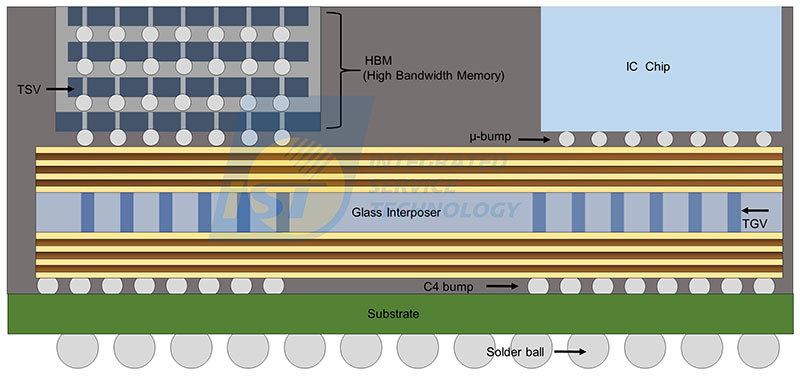
图一: TGV结构示意图
(图片来源:iST宜特科技)
跟「硅」这位老前辈相比,TGV的关键优势在于高频传输、绝缘性佳,可视为下一世代2.5D、3D等先进封装的重要技术之一,非常适合应用在 AI、5G、车用雷达等高速模块。然而,业界在导入 TGV 技术时,工艺良率、封装机械强度,以及材料热失配等问题,将是冲击可靠度验证结果与拖慢量产进度的重大瓶颈。
本篇宜特小学堂将根据宜特与业界的实务经验,分享我们如何透过一站式解决方案,四步骤找出产品失效的根本原因。最后也将分享一则实际案例,让您更深入了解 TGV 技术的应用与潜在风险。
TGV失效分析
TGV失效分析
一、目前TGV发展遇到的两大逆风:
二、时间就是金钱 四大解析步骤快速找出潜在异常点
接着,我们将不藏私地分享宜特故障分析实验室如何找出TGV玻璃基板的故障点。透过以下四大步骤,有效协助客户快速找出潜在故障点并加以改善,适用于TGV初期导入、材料选型、量产前可靠度验证等阶段。
(一) 创造环境,诱发异常点现形。
(二) 非破坏检视TGV缺陷所在区域,快速定位异常点。
(三) 异常点切片分析,了解实际失效现象。
(四) 微观材料结构分析,有效改善潜在风险。
步骤一:创造环境,诱发潜在异常点现形
透过加速老化可靠度实验,如HAST(Highly Accelerated Stress Test)与 HTS(High Temperature Storage),可评估 TGV 结构在高温/高湿/高压环境下的长期稳定性,藉此诱发出结构中可能存在的异常点。此方法可在短时间内模拟数年寿命,快速诱发铜扩散、玻璃界面剥离或导通异常等潜在问题。宜特可依客户需求调整测试条件(如85°C / 85%RH / 1000小时),并结合后段破坏分析,提高整体测试效能。
步骤二:非破坏检测TGV缺陷所在区域,快速定位异常点
当有相关电气漏电失效发生时,可利用亮点分析仪器 (Thermal EMMI或OBIRCH) 进行失效点定位;此外,采用高分辨率 X-Ray 系统,进行 2D 平面观察 与 3D 断层扫描,无需破坏样品,即可快速掌握 TGV 电性异常物性状态或铜填孔的完整性。此技术可识别TGV内部填镀常见的空洞(void)缺陷。我们也可针对高深宽比结构进行局部放大分析,作为后续精细切片的辅助依据。
步骤三:异常点切片分析,了解实际失效现象
在失效定位后,我们可针对异常与试片特性从 X-Section(断面研磨)、CP(Cross-section Polisher)、Plasma FIB各切片技术进行选择最佳制备方式进行精准剖面样品制备(阅读更多: IC切片手法有四种哪一种CP值最高,最适合你的样品?)
步骤四:微观材料结构分析,有效改善潜在风险
切片后可进一步搭配 SEM 或 TEM 观察穿孔界面状态,并利用 EDS / EELS 元素分析确认铜扩散路径与浓度分布,尤其在检测玻璃内部的微量铜扩散时,此步骤至关重要,有助于建立完整失效机制模型。亦可搭配EBSD分析晶粒大小/方向(Grain size/ orientation)、晶界(Grain boundary)特性与残留应力,有助改善工艺与提升可靠度和电气特性 (阅读更多: 揭密TGV工艺中的隐形杀手:EBSD如何破解应力难题)。
三、TGV案例分享
在宜特的TGV异常分析经验中,导致导通失败的主因多为TGV 工艺中「玻璃穿孔」的穿孔质量不良与「金属填孔」(多采用电镀或化学填镀)的铜填镀不均。由于 TGV 基板上的微小通孔需完全且均匀填入铜材,才能确保稳定导电路径,任何玻璃孔蚀刻异常都可能导致导通中断。同时,若电镀参数设定不当,易产生孔内空隙、填充不饱满或柱状结构不连续等缺陷,进而造成电气特性异常与封装失效。
在这个案例中,我们可利用 2D X-ray 非破坏分析,进行异常点定位,再搭配 精准切片,并以 SEM 观察发现铜填充空隙不均,导致部分 TGV 产生无法导通或高阻值异常。经分析后,针对镀铜条件进行优化与调整填镀时间,最终成功协助客户提升铜填孔饱和度与导电一致性,得以提升整体良率。
尽管硅中介层技术因「工艺成熟」与「散热佳」,仍是目前多数应用的主力。然而,TGV玻璃基板低电气阻抗、高频率传输与卓越的绝缘特性,成为半导体产业在AI加速器、高阶通讯及毫米波雷达等前瞻技术趋势下的关键材料之一。随着全球半导体大厂的积极投入,TGV玻璃基板有望成为先进封装领域中极具战略意义的「明日基板」技术。若能透过有效的故障分析手法加速协助提升TGV玻璃基板可靠度与其工艺良率,将可大大增加TGV及早量产化的可能性。
宜特验证分析实验室在TGV封装可靠度领域累积了多年的深耕经验,建立丰富的案例数据库可供借鉴。从TGV穿孔分析、加速老化可靠度实验,到后续的破坏性高分辨率观察,实验室配备完整的检测设备,包括HAST、电性亮点分析、2D/3D X-Ray、SEM、TEM、EDS、EELS、EBSD、XPS、SIMS等,提供一站式TGV测试能力。这将有助于加速TGV技术在多个应用领域的发展进程,推动高效能与高可靠度的突破。
本文与各位长久以来支持宜特的您分享经验,若您想要更进一步了解细节,欢迎洽询+886-3-579-9909 分机6741 李先生│Email: web_ISE@istgroup.com;marketing_tw@istgroup.com